半導体には必ず絶縁膜が必要です。
オゾンガスは、その絶縁膜を作る際に欠かせない材料です。
TMEICは、絶縁膜の品質低下の原因となる「窒素」を全く使わないでオゾンガスを発生する装置を開発しました。
発売した2004年以来、世界中の半導体工場で採用され、高品質な半導体の製造に貢献しています。
1. 窒素ガス無添加方式で超高濃度のオゾン発生
独自の電極構造により、最大450g/㎥(N)の業界トップクラスの超高濃度を達成。酸化膜の品質向上・成膜時間を短縮します。
2. 窒素ガス無添加方式で金属コンタミネーションの発生を抑制
配管やガス調整機器の表面より金属コンタミネーションを析出させる原因となる窒素酸化物の発生を極限まで抑えた*1
クリーンなオゾンガスは、更に微細化する半導体の歩留り低下を抑制します。
*1:窒素酸化物濃度0.01ppm以下(当社従来比1/10000)
3. 独自の極短ギャップ放電技術を採用
高評価を頂いている、安定性、冷却効果に優れた極短ギャップ放電技術を採用しています。
4. 国際規格に対応
欧州RoHS指令、CEマーキング、SEMIの国際規格に対応。世界中で安心して使用できます。
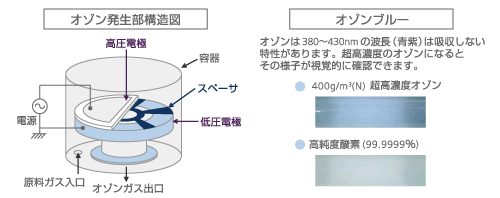
オゾンガス中の金属コンタミネーション量
単位:ng/m3
| 元素 | Na | Al | K | Ca | Ti | Cr | Mn | Fe | Ni | Cu | Zn |
|---|---|---|---|---|---|---|---|---|---|---|---|
| オゾンガス | N.D. | ||||||||||
| 検出限界 | 1.5 | 3.0 | 1.5 | 3.0 | 1.5 | 0.3 | 4.0 | 1.5 | 4.5 | 3.0 | 3.0 |
注1:参考値です。
金属コンタミネーションの原因となる「窒素」を全く使用しないため、オゾンガスに含まれる金属コンタミネーション量は、計測器の検出限界以下です。
※検出方法:マイクロ波導入プラズマ質量分析装置にて測定




